封装
你要进行巨大的时间尺度(以微秒为单位),并且必须以皮秒为单位回溯时间步骤。所以这是一个巨大的模拟挑战。而且设备水平的温度依赖性并不总是完全表征的。这些设备也处于全面开发阶段,因此光子学领域存在许多变化。
与 SoC 相比,Chiplet 技术具有显著的经济优势,未来十年有望实现高增长。芯片制造商可以使用不同技术和分辨率级别的组件定制最终芯片,从而提高成品率并降低成本。
先进封装正在成为通过取代减少现有晶圆电路线宽的预处理来提高芯片性能的替代方案。因此,各公司正专注于开发尖端封装技术,例如垂直堆叠芯片的3D、比现有塑料具有更高能效的玻璃基板,以及堆叠多个DRAM的HBM(高带宽内存)接合技术。
在后续发展上,三星在先进封装方面的布局有可能成为重点,成为Chiplet技术发展的重要力量,毕竟三星除了有制造、封装,该公司的HBM技术也处于全球第一梯队。
半导体封装是指将制造好的半导体芯片(也称为裸片或晶圆)封装在保护壳内,以提供物理保护、电气连接和热管理的过程。封装的主要目的是确保芯片在实际应用中能够稳定、可靠地工作,并且便于与其他电路或系统进行连接。
Chiplet方法代表半导体设计方法论的重大转变,但成功取决于解决几个关键挑战。行业需要在标准化与创新之间取得平衡,同时确保建模能力与设计需求同步发展。随着技术的成熟,预计将出现更多标准化方法和改进的建模技术,使基于Chiplet的设计更易于实现。
基于小芯片的架构正在重塑半导体格局。它通过解决传统单片设计的局限性,提供了一种可扩展、经济高效且高性能的替代方案。随着半导体服务和解决方案不断发展以支持这种范式转变,企业将通过采用这种变革性技术获得巨大收益。
尽管2024年传统市场复苏缓慢带来了一些短期挑战,但2025年及以后的中期展望对该领域的主要厂商而言依然乐观。AI和高性能计算(HPC)的快速发展将推动对先进封装解决方案的强劲需求,且地缘政治背景下对半导体基础设施的投资增加,加之在先进封装技术方面的持续资本支出,将助力后端设备市场实现持续增长。
尽管早期采用者不多,但用于先进节点的 FOPLP 仍在发展中。该技术必须克服实现高密度应用的均匀性和精度的重大障碍,而超过光罩尺寸 10 倍的芯片尺寸仍然是一个挑战,只有在进一步投资材料、工具和工艺创新后才能取得突破。然而,随着三星和台积电等行业巨头对其潜力的投资,FOPLP 有望在下一代封装解决方案中发挥关键作用。
活动
2025(第四届)半导体生态创新大会
 依托前三届半导体生态创新大会的举办经验与合作基础,中国电子商会联合多家行业机构共同组织召开的“2025(第四届)半导体生态创新大会”,旨在展现新时期行业最新的产品和前沿技术,锚定半导体发展前沿趋势,围绕创新链产业链融合的路径与轨迹,共话关键技术攻关新模式,识变应变拓展产业增长新空间,加快科技成果向现实生产力转化。
依托前三届半导体生态创新大会的举办经验与合作基础,中国电子商会联合多家行业机构共同组织召开的“2025(第四届)半导体生态创新大会”,旨在展现新时期行业最新的产品和前沿技术,锚定半导体发展前沿趋势,围绕创新链产业链融合的路径与轨迹,共话关键技术攻关新模式,识变应变拓展产业增长新空间,加快科技成果向现实生产力转化。




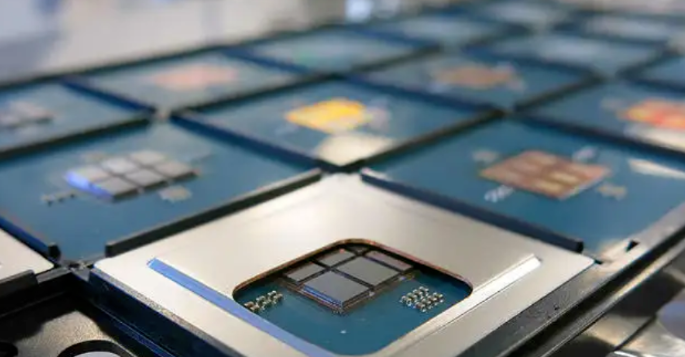
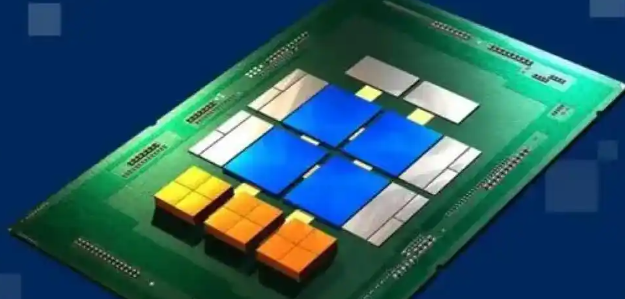
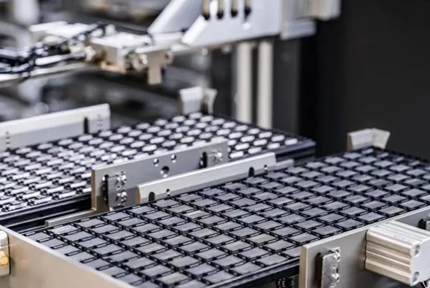

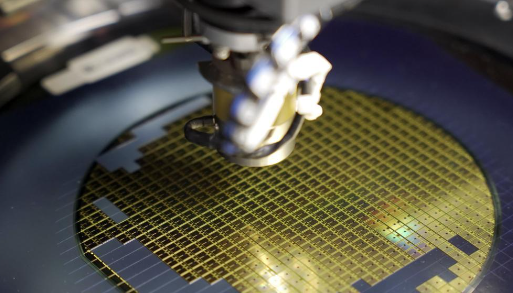
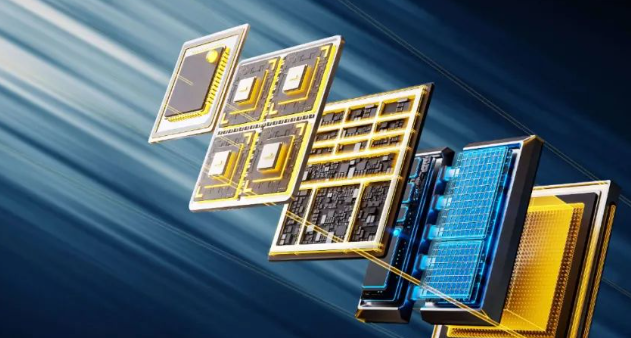




 2025年,《“数据要素×”三年行动计划(2024—2026年)》(以下简称《行动计划》)将进入落地执行的关键一年。深入推动数据要素市场化配置,将数据要素的乘数效应传递到各行业各领域,同时加快培育全国一体化数据市场,深入推进数据开发利用,从而激发全社会内生动力和创新活力,有力地促进数据经济高质量发展,已成为最重要、最紧迫的任务。
2025年,《“数据要素×”三年行动计划(2024—2026年)》(以下简称《行动计划》)将进入落地执行的关键一年。深入推动数据要素市场化配置,将数据要素的乘数效应传递到各行业各领域,同时加快培育全国一体化数据市场,深入推进数据开发利用,从而激发全社会内生动力和创新活力,有力地促进数据经济高质量发展,已成为最重要、最紧迫的任务。 本次活动由新华社品牌工作办公室指导,联合中国搜索、赛迪数通等多家权威机构共同发起,征集一批技术先进、经济可行、成熟可用的数实融合应用成果,并组织专家评委对征集到的成 果进行研究、论证、调查、评估 ,编制形成《2024新一代信息技术产业创新成果案例汇编》,进一步提升品牌培育质效,强化质量品牌建设,助力新一代信息技术赋能产业创新,为产业创新升级和高质量发展贡献力量。
本次活动由新华社品牌工作办公室指导,联合中国搜索、赛迪数通等多家权威机构共同发起,征集一批技术先进、经济可行、成熟可用的数实融合应用成果,并组织专家评委对征集到的成 果进行研究、论证、调查、评估 ,编制形成《2024新一代信息技术产业创新成果案例汇编》,进一步提升品牌培育质效,强化质量品牌建设,助力新一代信息技术赋能产业创新,为产业创新升级和高质量发展贡献力量。




