聊聊硅片尺寸与厚度的关系
在半导体制造中,硅片是制造集成电路和其他器件的基础材料,一般作为芯片的衬底存在。而硅片的尺寸和厚度是制程设计和性能优化中的重要因素。每一种尺寸都有其特定的应用领域,不同尺寸其对应的厚度也相应地有所不同,那么为什么硅片尺寸越大其厚度就越厚?硅片的尺寸与其厚度有什么关系呢?

不同尺寸硅片能在不同晶圆厂通用吗?
首先,一个晶圆厂一般会存在一到两种类型的硅片尺寸,比如一个通常所说的6inch晶圆厂通常会使用4-6inch的晶圆,而12inch的晶圆厂可能能够同时兼容8-12inch的晶圆。那么为什么每个晶圆厂只能接受范围如此窄的晶圆尺寸?那是因为晶圆厂中的机器设备能容纳的晶圆尺寸是固定的,一台12inch的机台,要做8inch的芯片产品,则需要更换夹具,配件等,过程十分繁琐。如果一家晶圆厂想从6inch向8inch升级,那么一般只能重新建厂,因为任何微不足道的更改都会造成工序的极大不稳定以及昂贵的改造费用。
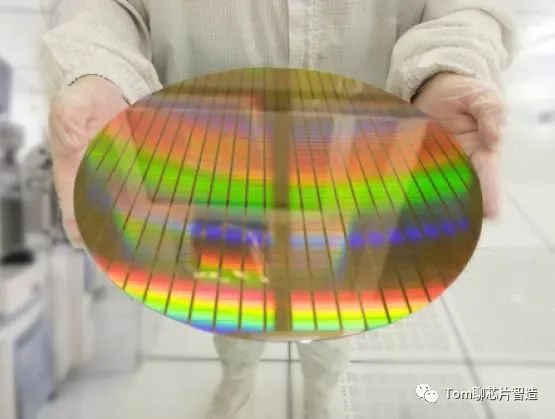
常见的硅片尺寸与厚度
一般常用的晶圆尺寸有4种:4inch,6inch,8inch,12inch。2inch的晶圆也有,但是在生产中并不多见,一般在实验室种用的较多。
对于直径为100 mm(4英寸)的晶圆,厚度通常约为525µm。
对于直径为150 mm(6英寸)的晶圆,厚度通常约为675µm。
对于直径为200 mm(8英寸)的晶圆,厚度通常约为725µm。
对于直径为300 mm(12英寸)的晶圆,厚度通常约为775µm。
以上列举的仅为常见厚度,根据工艺的要求,硅片厚度可以在适当的范围内浮动。
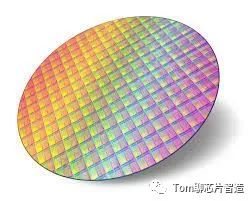
为什么硅片尺寸越大,硅片越厚?
晶圆的尺寸和厚度并非是随意选定的,而是根据制程要求和物理性质进行选择的。当晶圆尺寸变大时,为了保持其机械强度和翘曲度,同时避免在处理过程中因应力或弯曲而损坏,晶圆的厚度也会相应地增加。

机械强度:晶圆在制程中需要经受各种物理和化学处理,包括刻蚀、离子注入、氧化、扩散等。这些过程可能导致晶圆受到机械应力,如果晶圆太薄,可能会出现断裂或破损。
翘曲度:晶圆在处理过程中需要被搬运和定位。如果晶圆太薄,可能会出现弯曲,影响处理精度。
因此,随着晶圆直径的增大,为了保证晶圆的机械强度和翘曲度,晶圆的厚度也需要适当增加。但这也带来了一些挑战,比如热处理过程中的热传导问题、设备对晶圆厚度的适应性等,这些都需要在晶圆设计和制程开发中予以考虑。
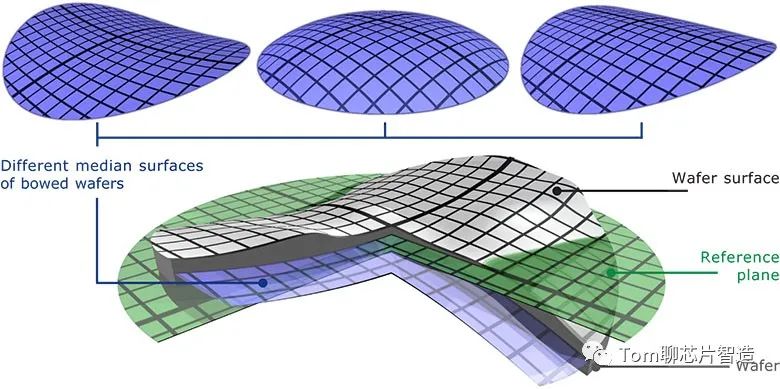
在半导体制造中,尽管大尺寸晶圆可以提供更多的芯片产量,但同时也带来了更多的制程挑战。这就需要通过制程优化,来平衡晶圆尺寸,厚度和应力控制的需求。




